|
지컴은 국내 최초 반도체 조립장비인 팬아웃 웨이퍼 레벨 패키지(FoWLP) 몰딩 장비를 개발했다. 파생상품으로 웨이퍼 핸들링(Wafer Handling) 공정에서 사용하는 필름 형태의 BG(Back Grinding)용 필름을 대체하는 웨이퍼 코팅(Wafer Coating) 장비도 개발해 상용화에 들어갔다.
이 제품은 기존 필름 대비 원부자재 비용을 최고 60% 이상 절감하고 BG 공정의 고질적 문제점인 모서리 깨짐·틈새 이물 등의 문제를 차단해 품질향상과 기술경쟁력 강화를 통한 시장 개척에 나서고 있다는 게 회사 측 설명이다.
이밖에 반도체 조립장비인 FOWLP 몰딩 장비는 국책과제(300㎜ 대응 대구경 다층구조의 복합 패키지 공정 및 장비 기술개발)로 5년간(2011~2016년) 서울테크노파크 등 국내 10개 기관이 함께 참여해 상용화에 박차를 가하고 있다.
김윤창(사진) 지컴 대표는 “고객 가치를 높이고 신뢰할 수 있는 제품을 만드는데 노력할 것”이라며 “반도체 테스트 산업 분야, 공정설비 분야에서 세계적 기업이 되겠다”고 말했다.


![월드컵까지 따냈다...스포츠산업 '생태계 파괴자' 된 빈살만[글로벌스트롱맨]](https://image.edaily.co.kr/images/Photo/files/NP/S/2023/11/PS23110500115t.jpg)

![[포토] 폭염 속 휴식취하는 건설 근로자](https://image.edaily.co.kr/images/Photo/files/NP/S/2023/08/PS23080100718t.jpg)

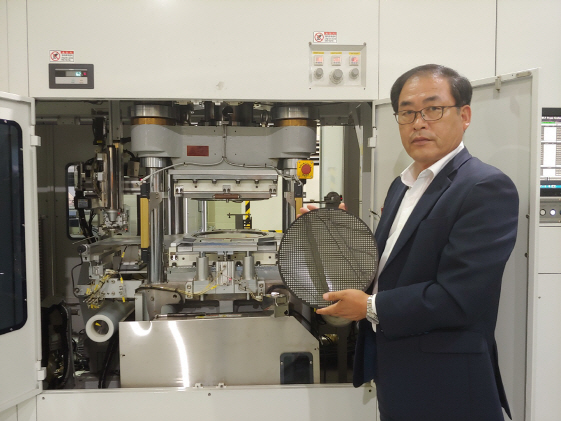






![[포토]책의날 맞아 시민들에게 책 나눠주는 유인촌 문체부 장관](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300692t.jpg)
![[포토] 안병우 축산경제 대표, 청정축산 환경대상 시상식](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300549t.jpg)
![[포토] 하나로마트 창립 29주년 70% 세일](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300533t.jpg)
![[포토]세계 책의 날 맞아 문체부, 국무회의에서 국무위원들에게 책 선물](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300428t.jpg)
![[포토]국내최대 오트 함량을 담은 어메이징 오트](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300304t.jpg)
![[포토]'원내대책회의 참석하는 윤재옥'](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042300287t.jpg)
![[포토]안전을 향한 닻을 올리자](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042200782t.jpg)
![[포토]BMW그룹 코리아, 'BMW 그룹 R&D 센터 코리아' 개관](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042200677t.jpg)
![[포토] 중소기업 금융애로 점검 회의](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042200646t.jpg)
![[포토]최은우 '대회 2연패 달성'](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/04/PS24042100415t.jpg)
