AI와 전장, 클라우드 등 앞으로 우리가 사용하는 첨단산업엔 지금과 달리 어마어마한 양의 반도체가 필요합니다. 단순히 스마트폰이 처리하던 정보량과 비교할 수 없는 수준입니다. 그러나 아무리 성능 좋은 반도체를 넣는다고 해도 ‘잘’ 연결하지 못하면 무용지물입니다. 반도체와 메인보드를 연결해 주는 기판이 바로 그런 ‘연결고리’ 역할을 하는 것이죠. 인간의 신경망과 같은 역할을 하는 FC-BGA 시장이 성장할 가능성이 커지면서 국내 기판업체들도 진입장벽 높은 기판 시장에 뛰어들었습니다. 반도체 기판은 무엇인지, FC-BGA는 무엇인지, 왜 중요한지 알아보겠습니다. [편집자주]
 | | LG이노텍의 플립칩(FC)-볼그리드어레이(BGA).(사진=LG이노텍) |
|
[이데일리 조민정 기자] 작디작은 반도체 칩은 매우 얇아 외부 타격에 취약하고 온도와 습도에도 매우 예민합니다. 반도체 기판은 메인 기판에 반도체 칩을 연결하고 반도체 칩이 손상되지 않도록 보호하는 역할을 합니다. 반도체와 메인 기판의 다리이자 동시에 외부 충격으로부터 보호해 주는 것이죠.
‘선’ 아닌 ‘볼’로 연결…속도 높이고 저전력반도체 기판은 어떤 기술로 반도체를 메인보드에 연결하는냐에 따라 이름이 달라지는데 종류가 매우 다양합니다. 중앙처리장치(CPU), 그래픽처리장치(GPU) 등 전기 신호가 많은 비모메리 반도체에 주로 쓰이는 ‘FC-BGA(Flip-chip Ball Grid Array, 플립칩 볼 그리드 어레이)’는 쉽게 FC와 BGA의 ‘합성어’라고 생각하면 편합니다.
 | | 반도체 패키지 기판의 구조.(사진=삼성전기) |
|
우선 플립칩(FC) 방식은 말 그대로 칩을 뒤집어 기판에 부착하는 방식입니다. 전통적인 와이어 본딩(Wire Bonding) 방식은 기판과 칩을 구리 선으로 연결해 속도가 느립니다. 반면 FC 방식은 뒤집은 칩에 공 모양의 부품인 범프(Bump)과 솔더볼(Solder Ball)을 붙여 기판과 직접 연결하니까 속도도 빠르고 저전력으로 정보를 처리합니다. 입출력(I/O) 단자가 많아지니 자연스럽게 성능도 좋아져 PC, 서버, 자율주행, 클라우드, 데이터 센터 등 어마어마한 처리량이 필요한 연산장치용 반도체에 쓸 수 있게 됩니다.
 | | 반도체와 기판을 잇는 기존 와이어 본딩(Wire Bonding) 방식(왼쪽)과 FC(플립칩) 방식.(사진=IBK투자증권) |
|
여기서 FC 방식은 또다시 △FC-CSP(플립칩 칩 스케일 패키지) △FC-BGA(플립칩 볼 그리드 어레이)로 나뉩니다. CSP는 반도체 칩과 기판 크기가 비슷해 ‘1기판 1칩’만 가능합니다. 기판 1개에 칩 1개만 장착할 수 있어서 칩을 추가로 넣을 자리가 마땅치 않아 스마트폰이나 애플리케이션 프로세서(AP) 등 상대적으로 크기가 작은 완성품에 들어갑니다.
반면 BGA는 칩보다 기판이 훨씬 커서 1개 기판에 반도체 칩을 여러 개 넣을 수 있다는 특징을 갖습니다. 남는 공간에 반도체를 추가로 넣을 수 있어서 기판 1개당 2개 이상의 반도체 칩이 들어갈 수 있으니 처리량도 CSP에 비해 많습니다. PC, 서버, 자동차, AI 등 크기가 큰 완성품에도 적합한 이유죠.
대표적으로 우리가 잘 알고 있는 애플의 프로세서인 M1, M2 칩에도 FC-BGA가 들어갑니다. 애플이 자체 개발한 반도체 M1 칩의 경우 FC-BGA를 이용해 애플 M1칩과 DDR4 메모리 반도체 2개를 한 번에 연결해 엄청난 성능을 자랑할 수 있었습니다. 위로 쌓아 올려 성능을 높이는 다른 기판과 달리 남는 공간에 여러 반도체 칩을 함께 부착해 고성능을 구현한 것입니다.
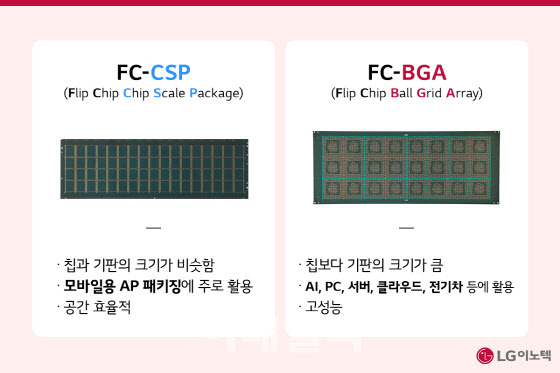 | | FC-CSP와 FC-BGA의 방식.(사진=LG이노텍) |
|
진입 장벽 높은 ‘고도화 기술’…공급난 우려FC-BGA의 구조를 쉽게 이해하기 어려운 만큼 이를 만들기 위해선 미세회로 구현, 대면적화, 층수 확대 등 고도의 기술력이 필요합니다. 다른 반도체 기판보다 상대적으로 고가의 소재를 사용해서 비용도 높은 편이고, 안정된 품질 관리 역량도 필요해 쉽게 뛰어들 수 없는 시장이죠. 글로벌 빅테크 기업들이 너도나도 FC-BGA를 원하고 있지만 그만큼 공급할 물량이 없어 공급난이 발생하는 가장 큰 이유입니다.
현재 전 세계에서 FC-BGA를 제조하는 기업은 10여 개에 불과합니다. FC-BGA 시장의 강자인 일본 이비덴, 신코와 대만 유니마이크론을 비롯해 한국에선
삼성전기(009150),
LG이노텍(011070),
대덕전자(353200),
코리아써키트(007810) 등 4개 기업이 FC-BGA 시장에 뛰어들어 사업을 진행하고 있습니다. 자체 고성능 칩을 개발하고 있는 애플, 구글, 아마존을 비롯해 AI를 중점으로 한 엔비디아 등 글로벌 빅테크 기업들이 반도체 기판을 원하는 수요에 비해 턱없이 부족한 숫자입니다.
시장조사기관 후지 키메라 종합 연구소는 글로벌 FC-BGA 기판 시장 규모가 2022년 80억 달러(약 9조 8800억원)에서 2030년에는 164억 달러(20조 2540억 원)로 연평균 9%가량 성장할 것으로 분석했습니다. 반도체 후공정 분야 시장조사기관 프리스마크는 2021년부터 2026년까지 5년 동안 FC-BGA 시장의 연평균 성장률이 11%에 이를 것으로 내다봤습니다.
지난해까지 지속된 FC-BGA 공급난은 올해 경기 침체 영향으로 잠시 주춤했지만 내년부터 AI 붐을 계기로 다시 수요와 공급 차가 벌어지면서 장기화할 전망입니다. 지난해 FC-BGA 기존 공급사들은 신규 설비 투자를 단행하긴 했지만 장비 수급의 지연 등으로 공급량이 실제로 증가하기까진 상당한 시간이 걸릴 예정이기 때문입니다. 게다가 서버용 FC-BGA는 챗GPT와 같은 생성형 AI에 적합한 만큼 업계에선 2027년까지 FC-BGA 공급난이 이어질 것으로 예상하고 있습니다.
 | | 반도체 후공정 분야 시장조사기관 프리스마크가 2021년 발표한 연간 글로벌 FC-BGA 수요와 공급 예상 그래프.(사진=LG이노텍) |
|


![월드컵까지 따냈다...스포츠산업 '생태계 파괴자' 된 빈살만[글로벌스트롱맨]](https://image.edaily.co.kr/images/Photo/files/NP/S/2023/11/PS23110500115t.jpg)

![[포토] 폭염 속 휴식취하는 건설 근로자](https://image.edaily.co.kr/images/Photo/files/NP/S/2023/08/PS23080100718t.jpg)




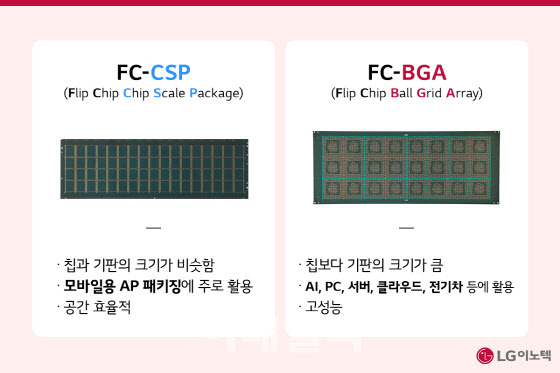



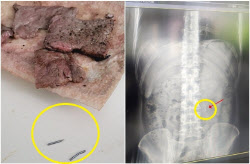



![[포토]박주영 '미소 출발 매치플레이'](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500142t.jpg)
![[포토]외국인 유학생들의 한글 받아쓰기 대회](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500363t.jpg)
![[포토]'봄비 맞으며'](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500326t.jpg)
![[포토]국토교통 혁신 이끌 첨단기술 모였다](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500285t.jpg)
![[포토]이마트, 기다렸던 '슈퍼와인 페스타'](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500242t.jpg)
![[포토]'단상 향하는 윤석열 대통령'](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500236t.jpg)
![[포토] '겨릿소 모내기 해봤소?'](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051400857t.jpg)
![[포토] 세종 관련 체험행사](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051400837t.jpg)
![[포토]맑고 파란 하늘과 광화문광장 분수대](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051400808t.jpg)
![[포토]홍현지 '승리의 브이로 출발'](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/05/PS24051500368t.jpg)
